正文
随着制程节点的变小,对EUV层的需求变多。
据ASML,代工厂7nm逻辑代工的EUV采用率增加了30%,预计下一个节点(5nm)的采用量将进一步增加50%,存储代工1A nm节点使用EUV层的数量亦显著增加,比16nm节点多50%。


台积电拥有最先进的制程,是全球7nm芯片代工市场的最大赢家。
随着GF(格罗方格)退出7nm及以下工艺的争夺,台积电在2018年最早实现了7nm 制程的突破并量产,斩获华为、苹果、AMD、高通等7nm芯片订单,并且台积电在VSLI峰会上表示,大多数TSMC的客户都表示将直接从TSMC 16nm节点工艺直接转到7nm节点工艺。
建议关注:中芯国际。
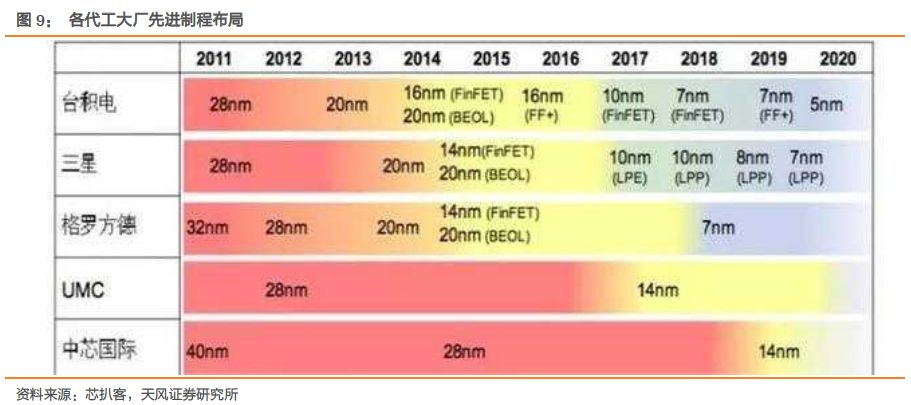
7nm制程于2018Q4为台积电贡献23%的收入,大超此前2019年才能突破20%的预期。
台积电表示,这是半导体史上第一次,最新工艺同时应用于所有产品领域,再加上首次引入EUV极紫外光刻的第二代7nm工艺,
台积电预计到2019年底会有100多款客户产品基于其7nm工艺
。
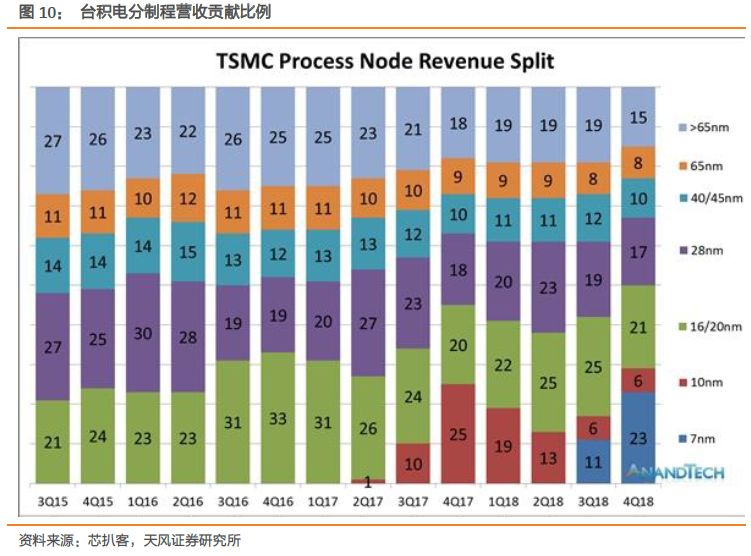
台积电在最先进制程上的领先优势有望维持。
工艺线的研发、制造设备的购买等均需要大量的资金、人才的支持,台积电凭借目前在7nm、7nm+EUV上的领先优势,在5nm、3nm制程上也早有布局。
其5nm 制程工艺预计在2020年实现量产,2023年有望量产3nm制程工艺。
龙头地位不可撼动,随着现有应用的升级和新兴应用的放量,台积电将长期受益于其最先进制程的领跑。

从5G SoC看SiP封装,国内封测龙头长电科技有望受益
小型化、微型化系统成趋势。
麒麟990 5G除了是全球首款使用7nm+EUV制程工艺的芯片外,还是
全球首款5G SoC芯片,
即在一颗芯片中同时封装了AP(应用处理器)和BP(基带处理器)。
目前,除麒麟990之外,业内其他几家有能力提供5G基带的厂商中,高通的一体SoC据称将在今年年底商用,而联发科的将在明年年初上市。
SoC是摩尔定律继续往下走的产物。
在麒麟990 5G发布之前,已发布的5G手机采用的都是外挂5G基带。
外挂基带存在不同程度的体积大、分量重、发热以及功耗高的问题,导致手机续航能力相比4G缩水不少。
而将
基带内置到SoC中,不仅能够节约主板空间,缓解发热问题,还可以有效地降低功耗,提升续航。
从封装发展的角度来看,因电子产品在体积、处理速度或电性特性各方面的需求考量下,
SoC 曾经被确立为未来电子产品设计的关键与发展方向。
半导体发展之路:遵循or超越摩尔定律。
摩尔定律发展到现阶段,行业内要继续往前走,有两条路径:
一是继续按照摩尔定律往下发展,走这条路径的产品有CPU、内存、逻辑器件等,这些产品占整个市场的约 50%。
超越摩尔定律的方法更加务实。
芯片发展从一味追求功耗下降及性能提升方面,转向更加务实的满足市场的需求的超越摩尔定律的More than Moore 路线。
这方面的产品包括了模拟/RF 器件,无源器件、电源管理器件等,大约占到了剩下的那 50%市场。

SiP 是实现超越摩尔定律的重要路径。
SoC与SiP封装都是实现在芯片层面上实现小型化和微型化系统的产物。
一般情况下, SoC 只集成 AP 之类的逻辑系统,而 SiP 集成了AP+mobileDDR,某种程度上说 SIP=SoC+DDR,随着将来集成度越来越高, emmc也很有可能会集成到 SiP 中。
随着摩尔定律越来越接近尾声, SoC生产成本越来越高,易遭遇技术障碍,从而使 SoC 的发展遇到瓶颈,进而 SiP 的发展越来越被业界重视。


SiP是智能手机RF前端重要的封装技术。
智能手机中的典型RF前端组件包括各种开关,滤波器,放大器和天线本身。
全球领先的公司越来越多地选择SiP技术来满足市场需求,例如实现越来越多的频段以及在更小的面积上开发电路,公司创建了高度集成的产品,优化了成本,尺寸和性能。
RF SiP成长空间相当大,未来以两位数的速度增长。
据Yole,2018年,RF前端模块SiP市场(包括第一级和第二级)的总额为33亿美元;
五年后,即2023年,预计CAGR将达到11.3%,达53亿美元。
到2023年,用于蜂窝和连接的RF前端SiP市场将分别占SiP市场总量的82%和18%。

2023年RF SiP市场总量的28%。
高端智能手机贡献43%的RF前端模块SiP组装市场,其次是低端智能手机(35%) )和豪华智能手机(13%)。
高通公司是5G RF解决方案的重要供应商,但它作为Fabless(无晶圆)公司,需要将所有SiP装配外包,这位OSAT带来了更多的商机。
以SiP为代表的先进封装需求不断扩大,长电科技是国内先进封装企业的代表。
Yole数据显示,2017年中国先进封装产值为29亿美元,占全球11.9%,到2020年将达到46亿美元,占全球14.8%。
数据显示,中国封测企业2018年在先进封装领域加速提高产能,增长率高达16%,是全球的2倍。
长电科技在收购星科金鹏之后,其先进封装产品出货量全球占比7.8%(2017年),排名第三,仅次于英特尔和矽品。
在自身技术的支撑和国产替代主题加持下,长电科技成长空间进一步打开。

长电科技目前在两种方向的先进封装均有布局。
先进封装技术有两大发展方向,一种是晶圆级芯片封装(WLCSP,也叫WLP),在更小的封装面积下容纳更多的引脚数;
一种是系统级芯片封装(SiP),该封装整合多种功能芯片于一体,可压缩模块体积,提升芯片系统整体功能性和灵活性。
长电科技在WLCSP、TSV、SiP、Bumping、FC、Fanout等先进封装上均有布局。
另外
建议关注华天科技/通富微电/环旭电子。

追加Capex表景气度回升。
长电科技在2019半年报中披露追加固定资产投资6.7亿元人民币,继续进行产能扩充,彰显公司对于行业未来发展的信心。
我们认为长电科技在2019H1业绩触底之后,市场情况将在2019H2迎来转机。

行情与个股
我们再次以全年的维度考量,强调行业基本面的边际变化,行业主逻辑持续。
【再次强调半导体设备行业的强逻辑】中国集成电路产线的建设周期将会集中在2018-2020年释放。在投资周期中,能够充分享受本轮投资红利的是半导体设备公司。我们深入细拆了每个季度大陆地区的设备投资支出。判断中国大陆地区对于设备采购需求是未来行业投资主线。核心标的:
北方华创/ASM Pacific/精测电子















