正文
目前流行的
MOS
管模型大致可分为两类,一类是基于阈值电压(
Threshold Voltage-based
)的模型,典型的代表为
BSIM3
和
BSIM4
,大家可以参阅
Razavi
的课本。它的一个典型特征就是阈值电压是
Vsb
的函数,以此来刻画体效应。这一类模型在深亚微米工艺下有较大的局限性。另一类基于电荷(
Charge-based
)的模型,其代表为
BSIM6
和
EKV
模型。
BSIM6
模型是现在仿真工具中的
CMOS
工艺的标准模型(
2013
年发布)。而
Abidi
教授在课堂上讲述的
EKV
模型,能够在手算过程中提供很多设计指导。(
EKV
,由其三位发明者
Enz
,
Krummenacher
,
Vittoz
的名字首字母命名)
如下图所示是一个
NMOS
的模型图。
MOS
管是四端器件,包括源端(
S
)、漏端(
D
)、栅端(
G
)和衬底(
B
)。在标准
CMOS
工艺中,所有
MOS
管共用一个
P
型衬底,为了防止
PN
结正偏,
P
型衬底一般接
GND
。
Vs
、
VD
、
VG
均相对于衬底电压定义。源极和漏极完全对称,逐渐增加栅极电压,在器件表面会出现反型层,对于
NMOS
来说,反型层由电子组成。反型层非常薄,其厚度可以近似忽略不计(
Charge-Sheet Approximation
),因而在分析中我们采用简单的一维模型。在图中以源极为原点,由源极引向漏极画出
x
轴。
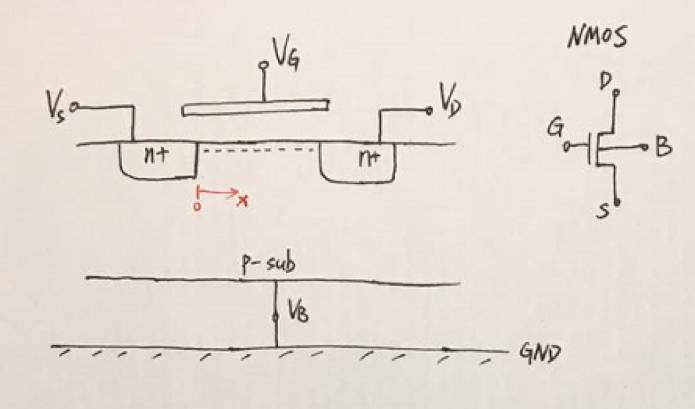
如下图所示,我们将坐标为
x
处反型层的面电荷密度记为
Q
inv
’(x)
,该处的沟道电压(相对于衬底)记为
V
ch
(x)
,

栅极、反型层和夹在中间的栅氧化层可以看出一个平行板电容器,则反型层面电荷密度与两极板间的电压的关系如下:

下面我们定义两个重要的概念:夹断电压(
V
p
, pinch-off voltage
)和阈值电压(
V
t0
, threshold voltage
)。在下图中,源极和漏极保持等电位,这样整个沟道的电势相同。如果固定
V
G
,当沟道电压增加至
V
p
时,反型层电荷密度减为
0
;如果固定沟道电压为
0V
,当
V
G
减为
V
t0
时,反型层电荷密度减为
0
。这里的阈值电压
V
t0
是定义在整个沟道等电位且电位为
0
的条件下,因而是一个定值,与之形成对比,传统模型中的阈值电压
V
TH
是
V
sb
的函数。另外值得注意的是,夹断电压
V
p
的定义不只在源极漏极等电位使才有效,只要沟道中某一点的电压
V
ch
(x)
大于
V
p
,在该点处沟道就会被夹断。
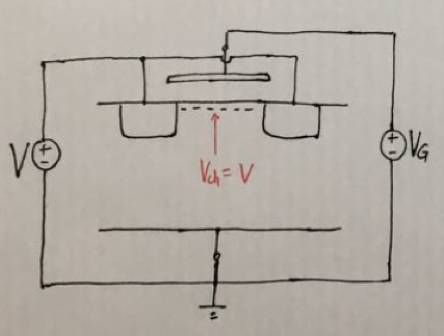
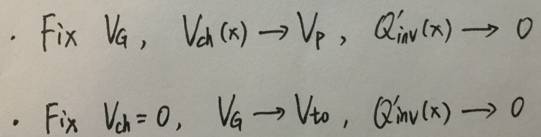
夹断电压和栅极电压的关系如下图所示,这种非线性是由反型层下方的势垒电容
C
dep
的非线性造成的(在介绍
MOS
管电容模型时我们会详细阐述)。为了简化模型,通常用一条斜率为
1/n
的直线来近似,即
V
p
= (V
G
-V
t0
)/n
。在之后的计算中我们采用
n = 1.5
。
注意:有的时候
V
p
与
VG-V
t0
的非线性关系会导致大信号偏置电路无法工作,具体地说,就是我们会推出
n
既大于
1
,又小于
1
,说明联立不等式无解。这个例子我们会在之后介绍偏置电路的时候举一个例子。

根据以上的近似,可以画出
Q
inv
’
和
V
ch
的关系。当
V
ch
= V
p
时,沟道被夹断,电荷密度为
0
;当
V
ch
= 0
时,
Q
inv
’= C
ox
’*(V
G
– V
t0
)
。细心的童鞋们可能已经注意到,下图的关系式与之前所列的平行班电容器的公式略有偏差,原因就是之前的公式是在忽略势垒电容
C
dep
的效应,或者说在
n= 1
的条件下推出的。

有了上面的铺垫,我们接下来推导电流的公式

















